光聯AI,芯載未來:面向智算的高性能CW光源!
ICC訊 在AI算力需求的強勁推動下,高速光模塊市場不斷迭代,主流產品已經逐步從400G切換到800G/1.6T,Lightcounting的最新預測顯示26年將迎來800G光模塊需求的爆發式增長。在AI光互聯中,針對100m以上的互聯場景往往以單模解決方案為主,底層光芯片解決方案主要分為兩類:傳統的EML方案、新興的硅光方案(SiPh)。其中EML方案憑借其優秀的傳輸特性主要用于FR等合波場景,在2km傳輸場景更具性價比;硅光方案以其天然的易集成優勢,多用于DR等多路并行場景,傳輸距離以500m應用居多。
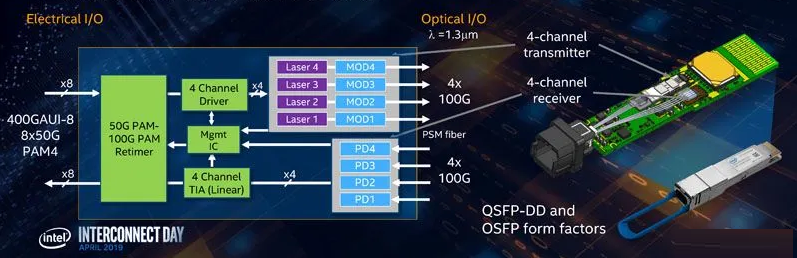
圖1:400G硅光光模塊架構(來源:Intel)
受限于硅材料本身特性的限制,目前硅光方案還需要通過外置光源耦合的方式為硅基芯片提供持續穩定的光輸入,這對外置光源激光器提出了更高要求:穩定的單模輸出、優異的高溫性能、高可靠性。當前硅光外置光源通常是采用工作在O波段的連續波(CW)分布反饋式半導體激光器(DFB)芯片。作為核心發光元件,CW DFB光源技術路線的選擇直接影響著光模塊的性能、可靠性與成本結構,如材料體系(InGaAsP /InGaAlAs)、波導結構(BH/RWG)及集成方案,從根本上決定了光模塊的性能上限、可靠性表現與成本構成。下文將系統剖析其關鍵影響因素與技術發展路徑。
CW DFB光源的波導結構設計
在CW DFB光源芯片中,為了實現穩定的單橫模輸出,必須引入有效的橫向光場和載流子限制結構。目前,掩埋型異質結(BH)和脊型波導(RWG)是業內兩種主流的波導結構設計,不同設計也決定了相應的激光器的性能、制造工藝和適用場景。以下列表對比說明兩種方案的優缺點:


圖2:BH結構和RWG結構差異示意圖
CW DFB光源的有源區材料選擇
除了波導結構設計,有源區材料體系的選擇對激光器性能,尤其是高溫性能,起著決定性作用。目前,有兩種主流有源區材料:InGaAlAs (鋁鎵銦砷)和InGaAsP (銦鎵砷磷),下表對比了兩種材料體系的優缺點:


圖3:InGaAlAs和InGaAsP材料能帶結構示意圖(來源FUJITSU)
CW光源技術路線對比
綜合考慮以上兩種波導設計和材料體系,目前主流的芯片設計方案主要包含如下三種:

因此,目前的市場上兩種可行的組合是BH+InGaAsP和RWG+InGaAIAs。
可靠性視角下的CW DFB光源 技術路線差異
DFB激光器的典型失效模式主要分為腔內失效和端面失效兩大類,不同技術方案的可靠性風險點各不相同. 下圖列舉了半導體激光器芯片的典型失效模式。

圖4:激光器芯片的典型失效模式 來源M. Fukuda / Microelectronics Reliability 47 (2007) 1619–1624
BH+InGaAsP方案的腔內可靠性挑戰
· 可靠性風險:二次外延再生長界面缺陷
· 失效機理:復雜的掩埋生長和刻蝕工藝在腔內引入的界面態、晶格缺陷等,可能成為非輻射復合中心,導致器件性能漸進性退化
· 質量控制:強烈依賴于極其精密的外延控制與界面處理工藝技術
RWG+InGaAlAs方案的端面可靠性解決方案
· 風險焦點:含鋁材料的端面氧化問題
· 解決方案:通過特殊的端面處理設備與工藝,如原位鈍化技術,在超高真空環境下完成端面清潔與介質膜沉積,顯著增強端面強壯性
實踐證明,通過優化端面工藝,RWG+InGaAlAs方案可實現極高的可靠性等級。
長光華芯CW光源系列產品
RWG + InGaAlAs方案綜合性能優異,工藝復雜度低,具備良好的可制造性,優勢十分顯著,但是依然存在一個技術挑戰:激光器出光端面(Facet)的鋁在解離后存在氧化的可能性,引發漸變性功率衰減甚至災變性光學損傷(COD),長期可靠性仍是亟待攻克的核心難點。
長光華芯在高功率半導體激光芯片方面有十余年研發和產品化經驗,高功率系列產品均基于脊型波導結構設計,為了解決高功率激光器芯片含鋁端面氧化問題,長光華芯成功開發了超高真空解離+原位端面鈍化技術,確保了端面在最潔凈的狀態下被完美“封存”, 從根本上解決端面氧化問題。采用該技術方案,長光華芯高功率半導體激光芯片累計發貨量達億顆級別,經過市場長期驗證,工藝成熟性與產品穩定性獲得市場廣泛認可。
基于高功率半導體激光芯片領域十余年的技術積累,長光華芯沿用成熟的RWG設計和端面鈍化工藝開發了硅光光源芯片,解決了長期可靠性難題,現已成功推出寬溫 70mW/100mW/200mW等 CW DFB光源產品,持續為高速硅光模塊提供高性能光源解決方案!
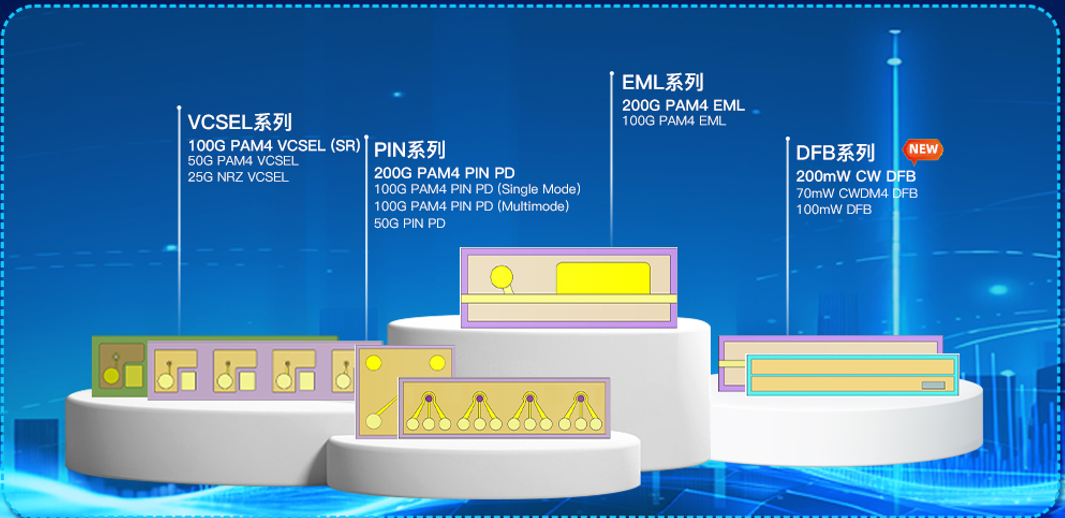
本文地址:http://www.limingkehu.com//Site/CN/News/2025/11/14/20251114104708934197.htm 轉載請保留文章出處
關鍵字:
文章標題:光聯AI,芯載未來:面向智算的高性能CW光源!
2、免責聲明,凡本網注明“來源:XXX(非訊石光通訊網)”的作品,均為轉載自其它媒體,轉載目的在于傳遞更多信息,并不代表本網贊同其觀點和對其真實性負責。因可能存在第三方轉載無法確定原網地址,若作品內容、版權爭議和其它問題,請聯系本網,將第一時間刪除。
聯系方式:訊石光通訊網新聞中心 電話:0755-82960080-168 Right
- · 中國移動啟動2026-2027年CWDM基站前傳設備集采 規模57.85萬套
- · 劍橋科技展望2026年:1.6T預計出貨占比約20% 800G將是出貨主力
- · Tower半導體Q3營收3.96億美元 加碼3億擴產硅光
- · Coherent財報會議解讀:需求分析、產能布局及未來展望
- · 硅光芯片企業孛璞半導體完成數億元A輪融資
- · Lumentum第一財季營收5.34億美元 同比增長58%
- · 破局“芯”困境,西北地區首條硅光中試線正式通線
- · 長光華芯:三季度營收增長凈利同比扭虧 光通信產品有望成為第二增長曲線
- · 蘇州易纜微榮獲第十四屆中國創新創業大賽新一代信息技術全國賽第一名
- · 海光芯正高速硅光光電器件及高速硅光模塊智能制造項目開工
- 設置首頁 | 光通訊招聘 | 企業搜索庫 | 廣告服務 | 聯系我們 | 保護私隱 | 公司介紹
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 訊石公司 www.limingkehu.com版權所有 粵ICP備12008183號-1
